Г. Виноградов, К. Медников: XORS‑200А – базовый модуль травления для массовых производств 65–32 нм
Проанализировано развитие технологии травления оксида кремния и других диэлектриков. Показано, что разработанный компанией АО «НПП ЭСТО» узкозазорный планарный модуль травления диэлектриков XORS‑200A представляет собой универсальный базовый реактор травления 200 мм для массового кремниевого производства с ключевыми параметрами уровня систем 300 мм и позволяет осуществлять как высокоаспектное травление диэлектриков, так и процессы мультипаттернинга.
Плазменное оборудование травления и осаждения слоев составляет до половины стоимости полупроводниковых производственных линий («фабрик»). И около половины этой стоимости относится к критическим процессам травления диэлектриков, осуществляемых на самом дорогом и сложном оборудовании. Его производство сосредоточено в настоящее время у двух гигантов полупроводникового машиностроения, компаний LAM Research USA (LAM) и Tokyo Electron Japan (TEL). Третий, самый крупный производитель оборудования для полупроводниковых производств, американская компания Applied Material (AMAT), не сумела удержать позицию в этой почетной и доходной рыночной нише.
На всех передовых полупроводниковых предприятиях (основные фабрики Samsung, INTEL, TSMC, SK HYNIX, Toshiba и др.) используются системы критического травления (Exelan Flex, Vigus и др.) обеих корпораций LAM и TEL. Оба производителя поставляют планарные узкозазорные емкостные реакторы, различающиеся не столько геометрией, сколько способами генерации и управления плазмой и высоковольтными электрическими слоями подложка-плазма, обусловленными, в основном, историей компаний и разработки этих систем во взаимодействии с массовыми производствами. Только на массовых полупроводниковых производствах производственное оборудование доводится до совершенства качества выпускаемых изделий, и именно полупроводниковое производство в истории человечества стало самым массовым, наукоемким, сложным и дорогим. Объем мирового рынка собственно полупроводниковых чипов (элементов) составляет около 500 млрд долл., а рынок оборудования более 60 млрд.
Критериями качества оборудования травления диэлектриков уровня front-end (первые слои на пластине с самыми малыми размерами структур) является его способность обеспечить целый комплекс структурных и динамических характеристик процесса для заданной технологической нормы. Главным и наиболее сложным тестовым процессом считается высокоаспектное травление оксида кремния или чередующихся слоев ONO (оксид-нитрид-оксид). Аспектное отношение характеризует ширину и глубину травимой канавки или отверстия. В современных устройствах динамической или флеш-памяти аспекты, отношение глубины к ширине, доходят до 30–50 и более. Другим, важным, но более легким процессом, является травление спейсеров затворов транзисторов первого слоя, которое характеризуется, главным образом, чрезвычайно высокой точностью контроля и аккуратностью проведения процесса. Весьма высокие аспектные требования начинают предъявляться и к травлению волноводов из окcида кремния в сложных устройствах фотоники.
Дороговизна процессов травления высокоаспектных диэлектрических структур HARC (High Aspect Ratio Contact) и UHAR (Ultra-High Aspect Ratio) обусловлена сложностью физико-химического механизма травления, который контролируется тонким балансом между осаждением тяжелых фторполимеров на поверхность пластины и удалением продуктов их реакций с травимым материалом (оксидом). Процесс настраивается таким образом, что оказывается чувствительным к материалу поверхности. Травится практически только оксид, а на остальной поверхности происходит осаждение полимера. Таким образом, достигается даже бесконечная селективность травления оксида по отношению к фоторезисту на горизонтальных поверхностях при весьма высокой энергии положительных ионов, бомбардирующих поверхность и производящих физическое распыление любых материалов, особенно на фацетах. Селективность травления фоторезиста на фацетах маски при типичном высокоаспектном травлении не превышает значения 5–7. При этом часть распыляемого материала переосаждается на поверхности самой обрабатываемой структуры, маскируя боковую поверхность структуры.
Именно этим обусловлена сложность контроля химии процесса и трудность контроля профиля травления и однородности нескольких параметров по площади пластины. Именно эта критичность механизма травления и является практическим запретом на применение объемных индуктивных плазменных источников ICP (inductively coupled plasma) для критического травления оксида. Объемные источники не обеспечивают достаточного малого времени пребывания газа в реакторе, чтобы провести необходимый контроль процессов на начальных стадиях химической кинетики превращений исходных газов, и не позволяют исключить вторичные реакции исходных компонентов, которые приводят к образованию множества неконтролируемых тяжелых соединений.
Индуктивные источники, тем не менее, обладают рядом преимуществ по отношению к емкостным. Однако длительное время никому не удавалось объединить преимущества индуктивных и планарных емкостных узкозазорных источников. Изобретение плоской конфигурации планарного индукционного источника типа ТСР (Transformer Coupled Plasma, LAM Research) приблизило реализацию такого реактора, однако, его объем все-таки в три-четыре раза превышает объем планарных узкозазорных емкостных реакторов, описанных выше, и поэтому не достигает цели, а потому и не применяется для травления высокоаспектных структур диэлектриков, хотя и используется вполне успешно в других процессах травления (кремний, металл).
Первый в мире узкозазорный планарный индуктивный реактор был разработан и доведен до уровня фабричного кластерного автомата японской компанией FOI Corporation (Future Oriented Instruments) при непосредственном участии автора статьи в качестве руководителя отделения исследований и разработок. Реактор изначально разрабатывался не только как принципиальная альтернатива емкостным реакторам критического травления, но и как более широкодиапазонная и предельно гибкая в управлении система травления, универсальный базовый реактор [1]. Таким реактором стал Groovy ICP, способный локально контролировать как физику плазмы, так и химический состав газа по радиусу обрабатываемой пластины в узком газоразрядном зазоре – таком же, как и у планарных емкостных разрядов. Таким образом, наиболее сильные качества индуктивных и емкостных реакторов были объединены в одном устройстве [2].
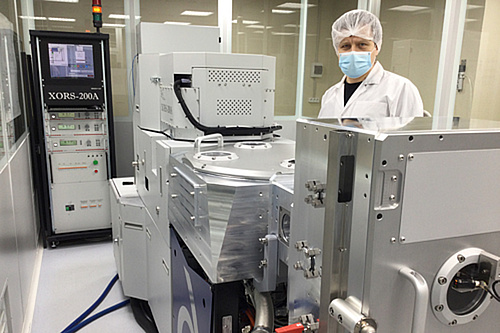
Кластерная система XORS‑200A с вакуумным перегрузчиком на три процессных модуля, лазерным ориентатором пластин и кассетным шлюзовым отсеком с элеватором.
Компанией АО «НПП ЭСТО» разработан модуль XORS‑200A критического травления диэлектриков 65–32 нм (субсидия Минпромторга России) на пластинах диаметром 200 мм с использованиемпередовых технологий травления современных 300‑мм фабрик. Затем «НПП ЭСТО» разработало и изготовило и кластерный вариант системы с центральным вакуумным перегрузчиком, ориентатором пластин и шлюзом с кассетным элеватором. По ключевым технологическим параметрам сам модуль превосходит все известные в мире 200-мм системы независимо от их типа. Поскольку XORS‑200A является масштабированной копией аналогичной 300-мм процессной камеры, воспроизводятся не только все технологии современной 300-мм системы, но и более высокий уровень всех параметров травления по стандартам 300-мм производства, включая чистоту производства.
Проблемой оказалось проведение опытных работ по травлению структур, используемых на отечественных предприятиях. Их размеры существенно превышают целевой диапазон технологических норм разработанного модуля: 65–32 нм. Поэтому тестирование проводилось на имеющихся отечественных образцах, показанных на фотографиях. Здесь представлены канавки, столбики, отверстия со слоями фоторезиста, контактными окнами. Показано травление не только оксида, но и поликремния. Проводилось также и глубокое травление монокристаллического кремния со свервысокими скоростями (до 20–30 мкм/мин) и гладкой стенкой без использования Bosch-технологии.
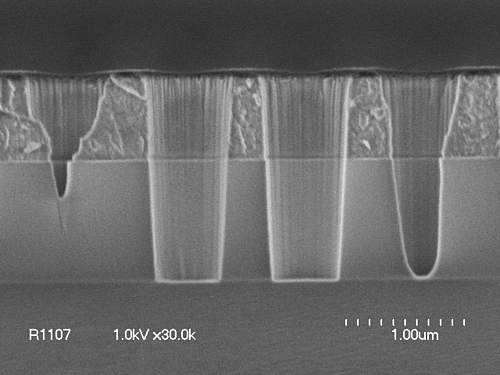
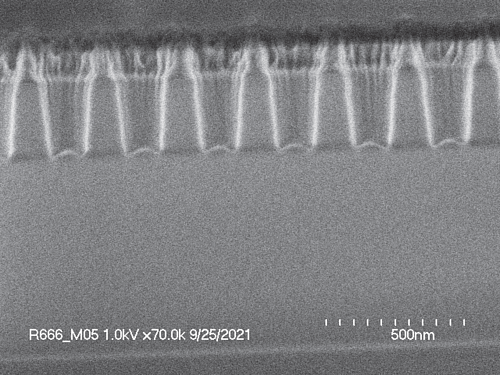
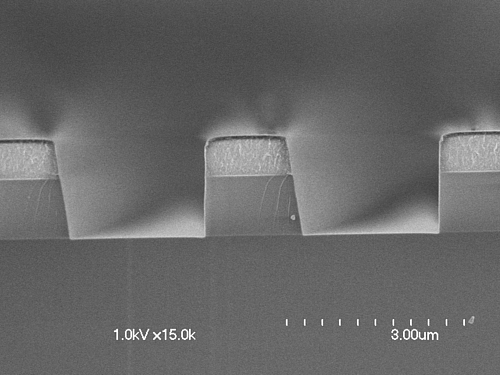
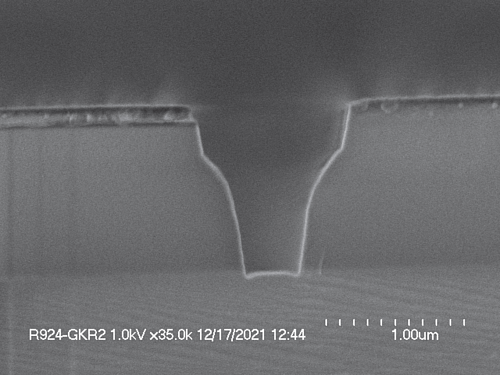
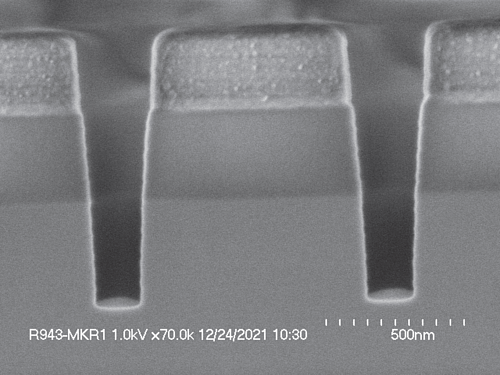
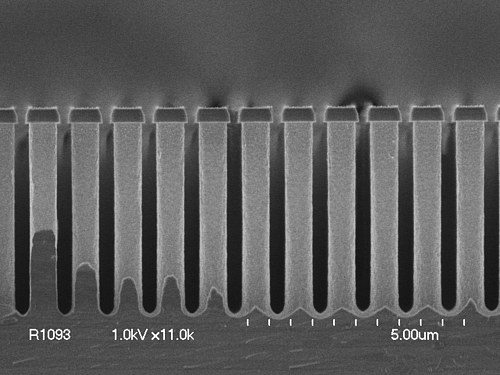
Примеры травления различных простых структур: а) контактное окно PR-SiO2 via, фоторезист не удален; б) контактные окна размером 90–100 нм, PR-SiO2, фоторезист без УФ-дубления; в) канавки PR-SiO2, фоторезист не удален; г) травление оксидного контактного окна и кремния PR-SiO2-Si, фоторезист не удален; д) травление кремниевых столбиков, оксидная маска подтравлена; е) травление контактных площадок типа wineglass в одном процессном цикле без использования камеры изотропного травления.
Благодаря возможности независимого локального управления физикой и химией процессов по радиусу пластины, а также широчайшему диапазону давления и мощности, характерному для источников ICP, модуль XORS‑200A позволяет разрабатывать новые рецептуры значительно проще и быстрее, чем на современных планарных системах ведущих иностранных производителей. Локальный независимый контроль параметров по радиусу позволяет разорвать самосогласованность плазменной рабочей среды, когда меняются все локальные параметры плазмы при изменении лишь одного внешнего параметра разряда, и принципиально расширить диапазон оптимизации процесса. Появляется возможность разорвать жесткую связь между однородностью процес- са по пластине, его скоростью и качеством травления.
Плазменное оборудование травления и осаждения слоев составляет до половины стоимости полупроводниковых производственных линий («фабрик»). И около половины этой стоимости относится к критическим процессам травления диэлектриков, осуществляемых на самом дорогом и сложном оборудовании. Его производство сосредоточено в настоящее время у двух гигантов полупроводникового машиностроения, компаний LAM Research USA (LAM) и Tokyo Electron Japan (TEL). Третий, самый крупный производитель оборудования для полупроводниковых производств, американская компания Applied Material (AMAT), не сумела удержать позицию в этой почетной и доходной рыночной нише.
На всех передовых полупроводниковых предприятиях (основные фабрики Samsung, INTEL, TSMC, SK HYNIX, Toshiba и др.) используются системы критического травления (Exelan Flex, Vigus и др.) обеих корпораций LAM и TEL. Оба производителя поставляют планарные узкозазорные емкостные реакторы, различающиеся не столько геометрией, сколько способами генерации и управления плазмой и высоковольтными электрическими слоями подложка-плазма, обусловленными, в основном, историей компаний и разработки этих систем во взаимодействии с массовыми производствами. Только на массовых полупроводниковых производствах производственное оборудование доводится до совершенства качества выпускаемых изделий, и именно полупроводниковое производство в истории человечества стало самым массовым, наукоемким, сложным и дорогим. Объем мирового рынка собственно полупроводниковых чипов (элементов) составляет около 500 млрд долл., а рынок оборудования более 60 млрд.
Критериями качества оборудования травления диэлектриков уровня front-end (первые слои на пластине с самыми малыми размерами структур) является его способность обеспечить целый комплекс структурных и динамических характеристик процесса для заданной технологической нормы. Главным и наиболее сложным тестовым процессом считается высокоаспектное травление оксида кремния или чередующихся слоев ONO (оксид-нитрид-оксид). Аспектное отношение характеризует ширину и глубину травимой канавки или отверстия. В современных устройствах динамической или флеш-памяти аспекты, отношение глубины к ширине, доходят до 30–50 и более. Другим, важным, но более легким процессом, является травление спейсеров затворов транзисторов первого слоя, которое характеризуется, главным образом, чрезвычайно высокой точностью контроля и аккуратностью проведения процесса. Весьма высокие аспектные требования начинают предъявляться и к травлению волноводов из окcида кремния в сложных устройствах фотоники.
Дороговизна процессов травления высокоаспектных диэлектрических структур HARC (High Aspect Ratio Contact) и UHAR (Ultra-High Aspect Ratio) обусловлена сложностью физико-химического механизма травления, который контролируется тонким балансом между осаждением тяжелых фторполимеров на поверхность пластины и удалением продуктов их реакций с травимым материалом (оксидом). Процесс настраивается таким образом, что оказывается чувствительным к материалу поверхности. Травится практически только оксид, а на остальной поверхности происходит осаждение полимера. Таким образом, достигается даже бесконечная селективность травления оксида по отношению к фоторезисту на горизонтальных поверхностях при весьма высокой энергии положительных ионов, бомбардирующих поверхность и производящих физическое распыление любых материалов, особенно на фацетах. Селективность травления фоторезиста на фацетах маски при типичном высокоаспектном травлении не превышает значения 5–7. При этом часть распыляемого материала переосаждается на поверхности самой обрабатываемой структуры, маскируя боковую поверхность структуры.
Именно этим обусловлена сложность контроля химии процесса и трудность контроля профиля травления и однородности нескольких параметров по площади пластины. Именно эта критичность механизма травления и является практическим запретом на применение объемных индуктивных плазменных источников ICP (inductively coupled plasma) для критического травления оксида. Объемные источники не обеспечивают достаточного малого времени пребывания газа в реакторе, чтобы провести необходимый контроль процессов на начальных стадиях химической кинетики превращений исходных газов, и не позволяют исключить вторичные реакции исходных компонентов, которые приводят к образованию множества неконтролируемых тяжелых соединений.
Индуктивные источники, тем не менее, обладают рядом преимуществ по отношению к емкостным. Однако длительное время никому не удавалось объединить преимущества индуктивных и планарных емкостных узкозазорных источников. Изобретение плоской конфигурации планарного индукционного источника типа ТСР (Transformer Coupled Plasma, LAM Research) приблизило реализацию такого реактора, однако, его объем все-таки в три-четыре раза превышает объем планарных узкозазорных емкостных реакторов, описанных выше, и поэтому не достигает цели, а потому и не применяется для травления высокоаспектных структур диэлектриков, хотя и используется вполне успешно в других процессах травления (кремний, металл).
Первый в мире узкозазорный планарный индуктивный реактор был разработан и доведен до уровня фабричного кластерного автомата японской компанией FOI Corporation (Future Oriented Instruments) при непосредственном участии автора статьи в качестве руководителя отделения исследований и разработок. Реактор изначально разрабатывался не только как принципиальная альтернатива емкостным реакторам критического травления, но и как более широкодиапазонная и предельно гибкая в управлении система травления, универсальный базовый реактор [1]. Таким реактором стал Groovy ICP, способный локально контролировать как физику плазмы, так и химический состав газа по радиусу обрабатываемой пластины в узком газоразрядном зазоре – таком же, как и у планарных емкостных разрядов. Таким образом, наиболее сильные качества индуктивных и емкостных реакторов были объединены в одном устройстве [2].
Кластерная система XORS‑200A с вакуумным перегрузчиком на три процессных модуля, лазерным ориентатором пластин и кассетным шлюзовым отсеком с элеватором.
Компанией АО «НПП ЭСТО» разработан модуль XORS‑200A критического травления диэлектриков 65–32 нм (субсидия Минпромторга России) на пластинах диаметром 200 мм с использованиемпередовых технологий травления современных 300‑мм фабрик. Затем «НПП ЭСТО» разработало и изготовило и кластерный вариант системы с центральным вакуумным перегрузчиком, ориентатором пластин и шлюзом с кассетным элеватором. По ключевым технологическим параметрам сам модуль превосходит все известные в мире 200-мм системы независимо от их типа. Поскольку XORS‑200A является масштабированной копией аналогичной 300-мм процессной камеры, воспроизводятся не только все технологии современной 300-мм системы, но и более высокий уровень всех параметров травления по стандартам 300-мм производства, включая чистоту производства.
Проблемой оказалось проведение опытных работ по травлению структур, используемых на отечественных предприятиях. Их размеры существенно превышают целевой диапазон технологических норм разработанного модуля: 65–32 нм. Поэтому тестирование проводилось на имеющихся отечественных образцах, показанных на фотографиях. Здесь представлены канавки, столбики, отверстия со слоями фоторезиста, контактными окнами. Показано травление не только оксида, но и поликремния. Проводилось также и глубокое травление монокристаллического кремния со свервысокими скоростями (до 20–30 мкм/мин) и гладкой стенкой без использования Bosch-технологии.
Примеры травления различных простых структур: а) контактное окно PR-SiO2 via, фоторезист не удален; б) контактные окна размером 90–100 нм, PR-SiO2, фоторезист без УФ-дубления; в) канавки PR-SiO2, фоторезист не удален; г) травление оксидного контактного окна и кремния PR-SiO2-Si, фоторезист не удален; д) травление кремниевых столбиков, оксидная маска подтравлена; е) травление контактных площадок типа wineglass в одном процессном цикле без использования камеры изотропного травления.
Благодаря возможности независимого локального управления физикой и химией процессов по радиусу пластины, а также широчайшему диапазону давления и мощности, характерному для источников ICP, модуль XORS‑200A позволяет разрабатывать новые рецептуры значительно проще и быстрее, чем на современных планарных системах ведущих иностранных производителей. Локальный независимый контроль параметров по радиусу позволяет разорвать самосогласованность плазменной рабочей среды, когда меняются все локальные параметры плазмы при изменении лишь одного внешнего параметра разряда, и принципиально расширить диапазон оптимизации процесса. Появляется возможность разорвать жесткую связь между однородностью процес- са по пластине, его скоростью и качеством травления.
